6.1 Introduction to the MOSFET
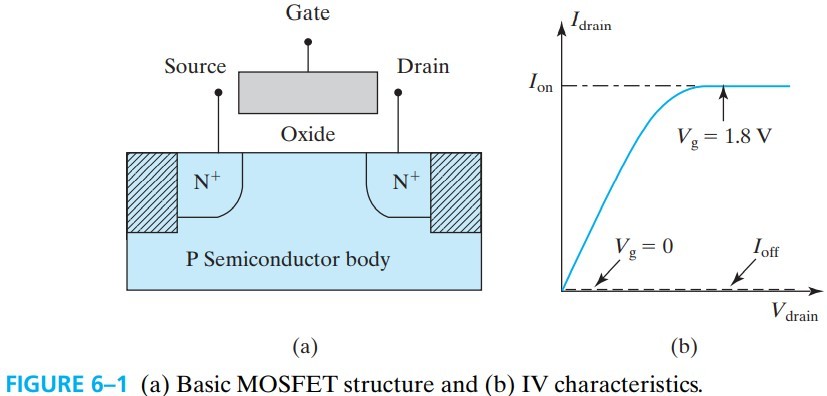
MOSFET 的基本结构如上,左右两个 PN 结叫 source 和 drain,一个用于输入载流子,另一个则用于流出载流子。 FET 代表 field-effect transistor,指的是用过 gate 来开关 transistor,当 $V_g>V_t$ 时,就有电流(如图 fig 6-1b). 图中斜阴影部分叫 shallow-trench-isolation. ${\rm Si-SiO_2}$ 表面有很高的 threshold voltages $V_t$,从而避免产生 inadvertent surface inversion path
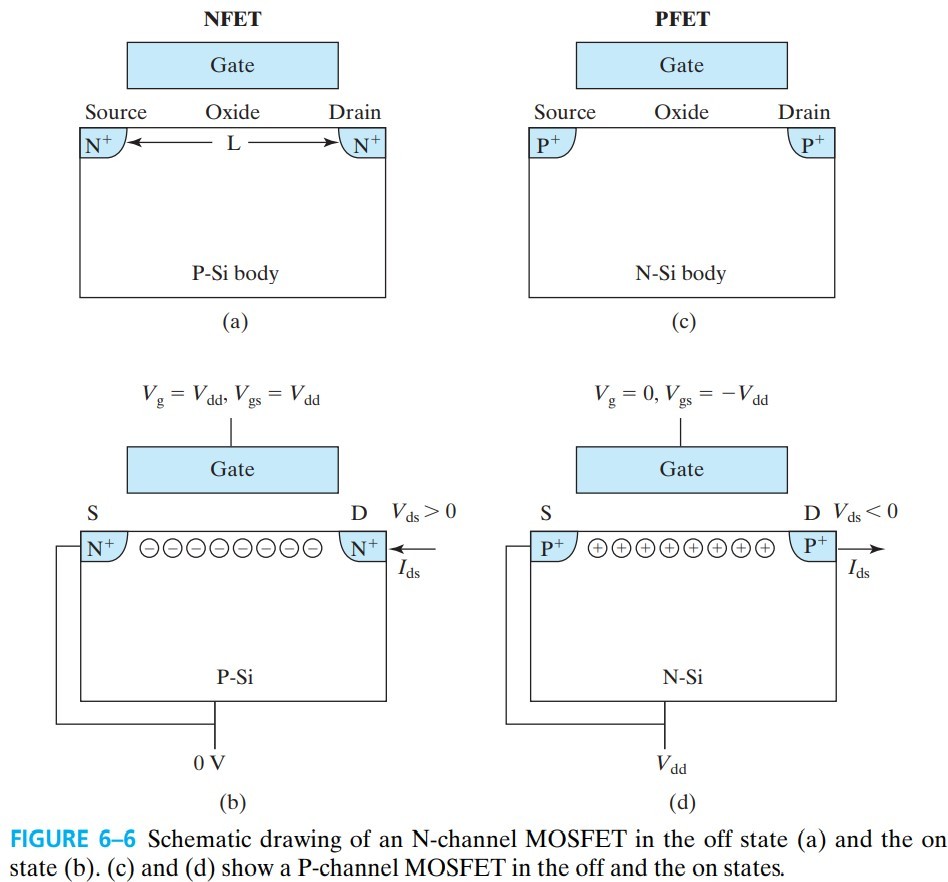
- N-channel MOSFET
- The conduction channel (i.e., the inversion layer) is electron rich or N-type(Fig. 6–6b)
- Body is connected to the lowest voltage, 0V
- When $V_g=V_{dd}$, on
- P-channel MOSFET
- The conduction channel is hole rich or P-type
- Body is connected to the lowest voltage, $V_{dd}$
- When $V_g=0$, on
$V_{dd}$ 是 power-supply voltage. 从上可以看出,NFET 和 PFET 的工作方式恰好相反。
实际电路中两种 FET 都有用到,称为 CMOS or complementary MOS circuits
6.3 Surface Mobilities and High-Mobility FETs
我们希望 MOSFET 能导通大电流,并且能快速对电容 $C_\text{oxe}$ 充放电,所以我们需要研究 inversion layer 的载流子 mobility
设加一个小电压 $V_{ds}$,则电流 $I_{ds}$ 为:
\[\begin{aligned} I_{ds}&=W\cdot Q_\text{inv}\cdot v\\ &= W Q_\text{inv} \mu_{ns} \mathscr{E}\\ &= W Q_\text{inv} \mu_{ns} V_{ds}/L\\ &=W C_\text{oxe} (V_{gs}-V_t)\mu_{ns} V_{ds} / L \end{aligned} \tag{6.3.1}\]其中,
- $W$ 是 channel width(横截面)
- $Q_\text{inv}\;{\rm (C/cm^2)}$ 是 inversion charge density(见公式 $(5.5.3)$)
- $\mathscr{E}$ 是channel electric field
- $L$ 是 channel length
- $\mu_{ns}$ 是 electron surface mobility,也叫 effective mobility
- 我们规定 $I_{ds}$ 方向在 NFET 中是 D-to-S 为正,在 PFET 中是 S-to-D 为正,故它始终是正的
表面处的 $\mu{ns}$ 和 $\mu_{ns}$ 比体内小,它与 inversion charge layer 中的平均电场有关。我们设 inversion charge layer 上下表面的电场分别为 top:$\mathscr{E}_t$ 和 bottom:$\mathscr{E}_b$,可以用下面公式求出:
\[\mathscr{E}_b = -Q_\text{dep}/\varepsilon_s \tag{6.3.2}\]根据 $(5.4.4)$,有:
\[V_t = V_\text{fb}+\phi_{st}-Q_\text{dep}/C_\text{oxe}\]所以有:
\[\mathscr{E}_b = \frac{C_\text{oxe}}{\varepsilon_s}(V_t-V_\text{fb}-\phi_{st}) \tag{6.3.4}\] \[\begin{aligned} \mathscr{E}_t &= -(Q_\text{dep}+Q_\text{inv})/\varepsilon_s\\ &=\mathscr{b}-Q_\text{inv}/\varepsilon_s\\ &=\mathscr{b}-\frac{C_\text{oxe}}{\varepsilon_s} (V_{gs}-V_t)\\ &= \frac{C_\text{oxe}}{\varepsilon_s} (V_{gs}-V_\text{fb}-\phi_{st}) \end{aligned}\]
对 inversion layer 使用高斯定理,有:
\[\begin{aligned} \frac{1}{2}(\mathscr{E}_b+\mathscr{E}_t) &= \frac{C_\text{oxe}}{2 \varepsilon_s}(V_{gs}+V_t-2V_\text{fb}-\phi_{st})\\ &\approx \frac{C_\text{oxe}}{2 \varepsilon_s}(V_{gs}+V_t+0.2 \text{V})\\ &= \frac{\varepsilon_\text{ox}}{2 \varepsilon_s T_\text{oxe}} (V_{gs}+V_t+0.2 \text{V})\\ &= \frac{V_{gs}+V_t+0.2 \text{V}}{6 T_\text{oxe}}\\ & \text{ for }{\rm N^+}\text{ poly-gate NFET} \end{aligned} \tag{6.3.6}\]$\mu_{ns}$ 与 $(\mathscr{E}_b+\mathscr{E}_t)/2$ 或与 $Q_\text{dep}+Q_\text{inv}/2$ 有一定函数关系,对实验数据拟合后可以得到 $(6.3.7)$:
\[\mu_{ns} = \frac{540 {\rm cm^2/Vs}}{1+\left( \dfrac{V_{gs}+V_t+0.2\text{V}}{5.4 T_\text{oxe}} \right)^{1.85}} \tag{6.3.7}\]类似的,$\mu_{ns}$ 与 $(\mathscr{E}_b+1.5 \mathscr{E}_t)/2$ 也有一定关系:
\[\mu_{ps} = \frac{185 {\rm cm^2/Vs}}{1-\left( \dfrac{V_{gs}+1.5V_t-0.25 \text{V}}{5.4 T_\text{oxe}} \right)} \tag{6.3.8}\]这俩公式看起来怪恐怖的。在 NFET 中 $V_{gs}$ 和 $V_t$ 为正,在 PFET 中 $V_{gs}$ 和 $V_t$ 为负。当 $(\mathscr{E}b, \mathscr{E}_t)$ 增强时,$\mu{ns}$ 和 $\mu_{ps}$ 会减小,因为电场越大,载流子就越靠近表面,就容易受 surface roughness scattering 影响。
晶面指数对 $\mu_s$ 也会有影响,所以我们选择 $[100]$ 面,此时的 $\mu_{ns}$ 最大,但 $\mu_{ps}$ 不是最大。
6.4 MOSFET Vt, Body Effect, And Steep Retrograde doping
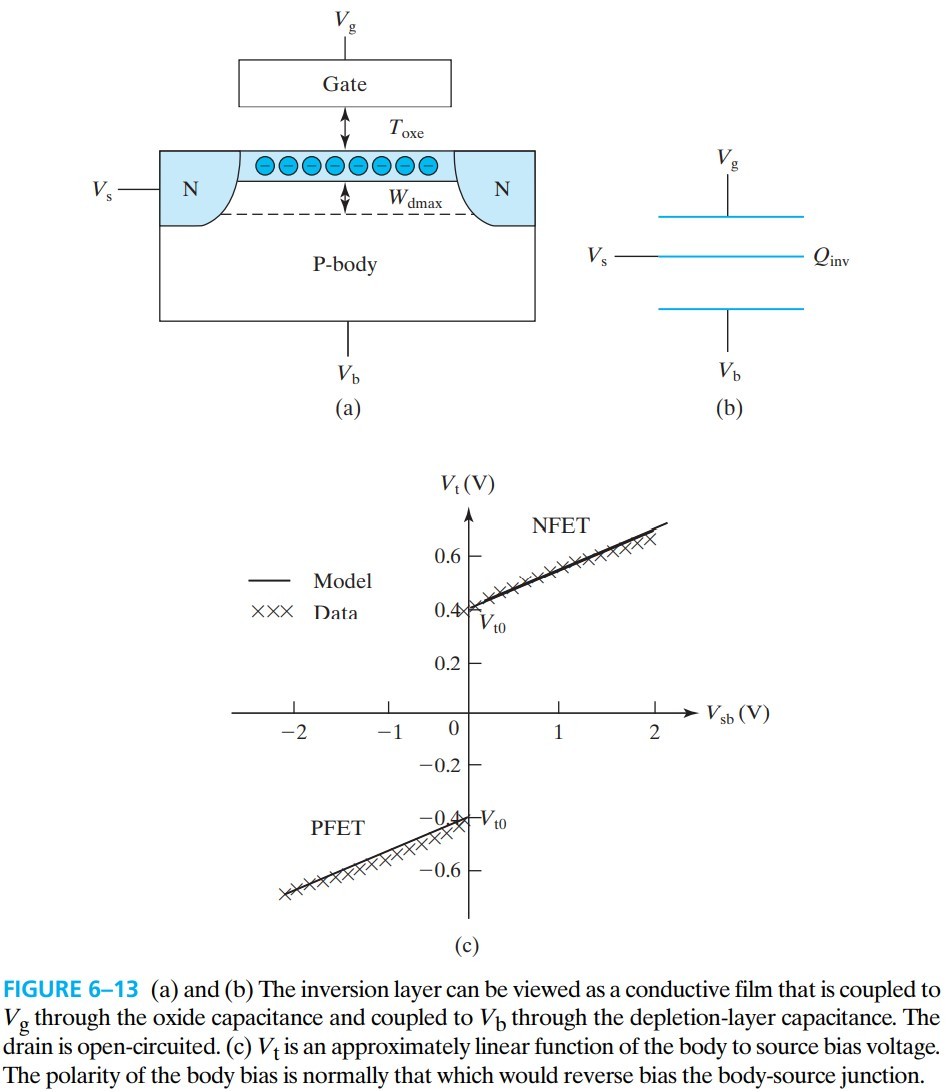
我们将 inversion layer 看作一个连接 source 和 drain 的 N-type film,上面的电压为 $V_s$. 该薄层与 gate 形成了一个电容,同时与下面的 depletion layer 也形成了电容。这两个电容我们在 $(5.6.2)$ 和 $(5.5.3)$ 中求过,这里再写一次:
\[C_\text{dep} = \frac{\varepsilon_s}{W_\text{dmax}} \tag{6.4.1}\] \[Q_\text{inv} = -C_\text{oxe} (V_{gs}-V_t) \tag{6.4.2}\\ 负号是因为电压与电荷不在同一极板\]如果我们在 source 和 body 之间加一电压 $V_{sb}$,这样相当于在 $C_\text{dep}$ 加电压,所以 $(6.4.2)$ 变为:
\[\begin{aligned} Q_\text{inv} &= -C_\text{oxe}(V_{gs}-V_t)+C_\text{dep}V_{sb}\\ &= - C_\text{oxe}\left( V_{gs} - \left( V_t + \frac{C_\text{dep}}{C_\text{oxe}} V_{sb}\right) \right) \end{aligned} \tag{6.4.4}\]我们可以将 $V_t$ 看作是 $V_t(V_{sb})$,从而(用 $V_{t0}$ 代替原来的 $V_t$):
\[Q_\text{inv} = -C_\text{oxe} (V_{gs} - V_t(V_{sb})) \tag{6.4.5}\] \[V_t(V_{sb}) = V_{t0}+\frac{C_\text{dep}}{C_\text{oxe}} V_{sb}=V_{t0}+\alpha V_{sb} \tag{6.4.6}\\ \alpha = C_\text{dep}/C_\text{oxe} = 3 T_\text{oxe}/W_\text{dmax}\]式子中的 3 来自于硅和二氧化硅的介电常数比值。
我们将 $V_t$ 受 body bias 调控的现象称为 body effect,$\alpha$ 称为 body-effect coefficient. 一般来说,我们不会让 source 和 body 形成 forward bias,否则会产生电流。当然,我们也不希望 reverse bias,因为这样会增大 $V_t$,减小 $I_{ds}$,减慢速度。要减小 body effect,可以 minimizing the $T_\text{ox}/W_\text{dmax}$ ratio,即使用 thin oxide
现代 transistor 都采用 steep retrograde body doping profiles(表面浓度远大于内部),这样 $\alpha$ 不随 $V_{sb}$ 变化。以前的 MOSFETS 的浓度都是线性变化的,导致 $V_t$ 与 $V_{sb}$ 并不是线性关系,我们可以将 $(5.4.3)$ 中的 $2\phi$ 项替换成 $2\phi+V_{sb}$:
\[\begin{aligned} V_t &= V_{t0}+\frac{\sqrt{q N_a 2 \varepsilon_s}}{C_\text{oxe}}(\sqrt{2 \phi_B+V_{sb}} - \sqrt{2 \phi_B})\\ &\equiv V_{t0} + \gamma(\sqrt{2 \phi_B+V_{sb}} - \sqrt{2 \phi_B}) \end{aligned} \tag{6.4.8}\]$γ$ is called the body-effect parameter
6.5 Qinv in MOSFET
考虑在 drain 上加一电压 $V_d$(如图 fig 6-15),这样沟道上的电压 $V_c$ 随 $x$ 变化,我们写成 $V_c(x)$
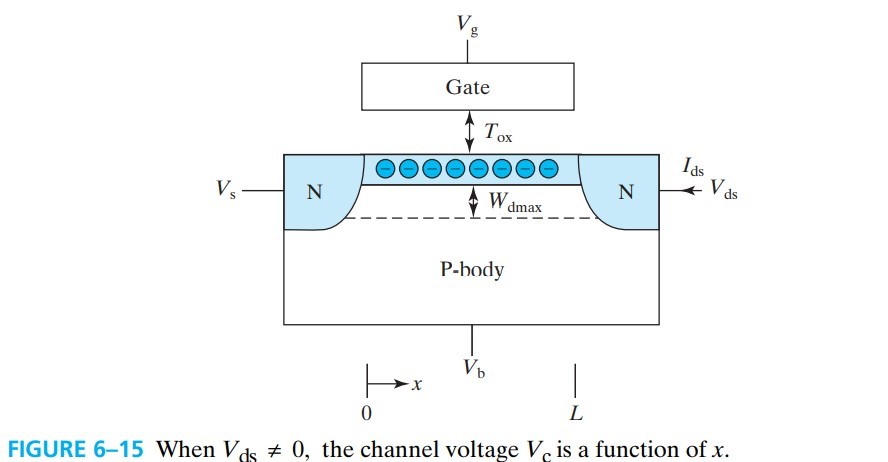
原本 $C_\text{oxe}$ 上的电压是 $V_g$,现在则变成了 $V_g-V_c(x)$,这么一来 inversion layer 上的电荷就会减少:
\[Q_\text{inv}(x) = -C_\text{oxe} (V_{gs} - V_t(V_{sb})) \tag{6.4.5}\\ \Downarrow\] \[\begin{aligned} Q_\text{inv}(x) &= -C_\text{oxe} (V_{gs}-V_{cs} - V_t(V_{sb}+V_{cs}))\\ &= -C_\text{oxe} (V_{gs}-V_{cs} - V_{t0} - \alpha(V_{sb}+V_{cs}))\\ &=-C_\text{oxe} (V_{gs}-V_{cs} - (V_{t0} + \alpha V_{sb}) -\alpha V_{cs})\\ &= -C_\text{oxe} (V_{gs}-(1+\alpha)V_{cs} - (V_{t0} + \alpha V_{sb}))\\ &=-C_\text{oxe} (V_{gs}-mV_{cs} - (V_{t0} + \alpha V_{sb})) \end{aligned} \\\tag{6.5.1} m \equiv 1+\alpha = 1+C_\text{dep}/C_\text{oxe}=1+3 T_\text{oxe}/W_\text{dmax}\]$m$ 一般在 $1.2$,但为了方便计算可以取 $1$.
(下面这段话我觉得放在 6.4 会比较合适)有时候我们也把 body 叫 back gate,因为它也能调控 channel charge. 这种调控 $Q_\text{inv}$ 的能力叫 bulk-charge effect,$m$ 叫 bulk-charge factor
6.6 Basic MOSFET I-V Model
还记得 $(6.3.1)$ 的公式吗?我们把 $Q_\text{inv}(x)$ 代入:
\[\begin{aligned} I_{ds} &= W\cdot Q_\text{inv}(x) \cdot v\\ &=W\cdot Q_\text{inv}(x) \cdot \mu_{ns} \mathscr{E}\\ &=W \cdot C_\text{oxe} (V_{gs} - V_t-mV_{ds}) \cdot \mu_{ns} \frac{\dif V_{ds}}{\dif x} \end{aligned} \tag{6.6.1}\]将 $\dif x$ 移到左边,然后对 $I_{ds}$ 积分,得到:
\[I_{ds} = \frac{W}{L} C_\text{oxe}\mu_{ns} \left(V_{gs} - V_t-\frac{m}{2}V_{ds}\right)V_{ds} \tag{6.6.4}\]当 $V_{ds}$ 很小时,我们可以忽略 $\frac{m}{2}V_{ds}$ 项,此时 transistor 就像一个 resistor. 我们可以求出电阻:
\[\frac{\dif I_{ds}}{\dif V_{ds}} =\frac{W}{L} C_\text{oxe}\mu_{ns} \left( V_{gs} - V_t-mV_{ds} \right)\]令电阻为 $0$,可以求出:
\[V_{ds} = V_\text{dsat} = \frac{V_{gs}-V_t}{m} \tag{6.6.5}\]$V_\text{dsat}$ 称为 drain saturation voltage,当到达这个电压后,再增大 $V_{ds}$,电流也不会变大(毕竟电阻怎么也不会变成负的吧……),最大电流为:
\[I_\text{dsat} = \frac{W}{2 m L}C_\text{oxe} \mu_{ns} (V_{gs}-V_t)^2 \tag{6.6.6}\]如果我们将 $V_{ds}$ 代回 $(6.5.1)$,会发现此时 $Q_\text{inv}=0$,即 inversion layer 不见了。我们称为 channel pinch-off. 如果持续增大 $V_{ds}$,会出现一个 pinch-off region,across which the voltage $V_{ds} − V_\text{dsat}$ is dropped。(如图 fig 6-17e,h)the pinch-off region does not present a barrier to current flow,所以电流不变。

我们可以将 I-V 曲线划分成三个区:
- $V_{ds} \ll V_\text{dsat}$ 称为 linear region
- $V_{ds} \gt V_\text{dsat}$ 称为 saturation region,也称为 Ohmic region 或 active region.
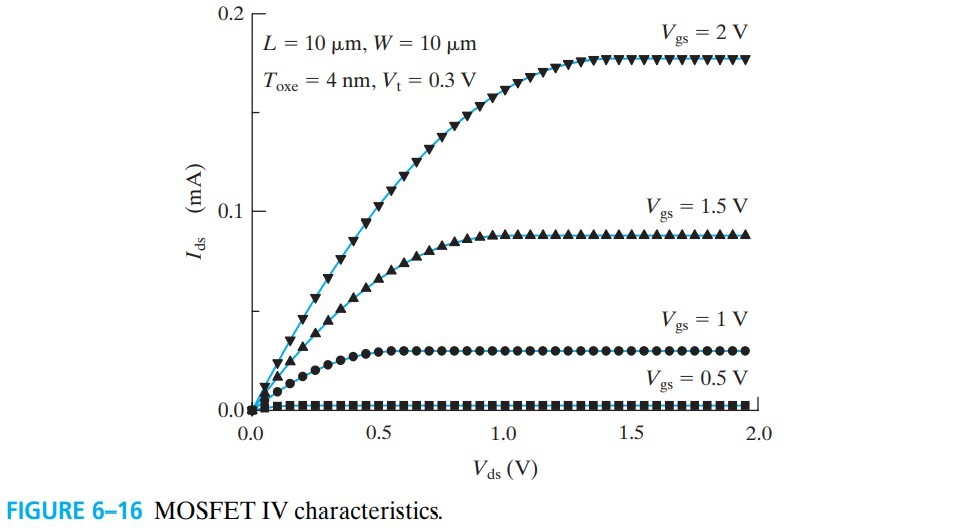
我们用 Transconductance 来衡量 $V_{gs}$ 对电流的控制能力(电流对 $V_{gs}$ 的敏感程度):
\[g_m \equiv \left. \frac{\dif I_{ds}}{\dif V_{gs}} \right|_{V_{ds}}\]由 $(6.6.4)$ 可以求出:
\[\begin{aligned} g_m &= \frac{W}{L} C_\text{oxe}\mu_{ns} V_{ds}\\ & \leq \frac{W}{L} C_\text{oxe}\mu_{ns} V_\text{dsat}\\ &= \frac{W}{mL} C_\text{oxe}\mu_{ns} (V_{gs}-V_t)\\ &= g_\text{msat} \end{aligned} \tag{6.6.9}\]6.7 CMOS Inverter - A Circuit Example
下面我们来分析一个简单的CMOS电路实例——反相器。
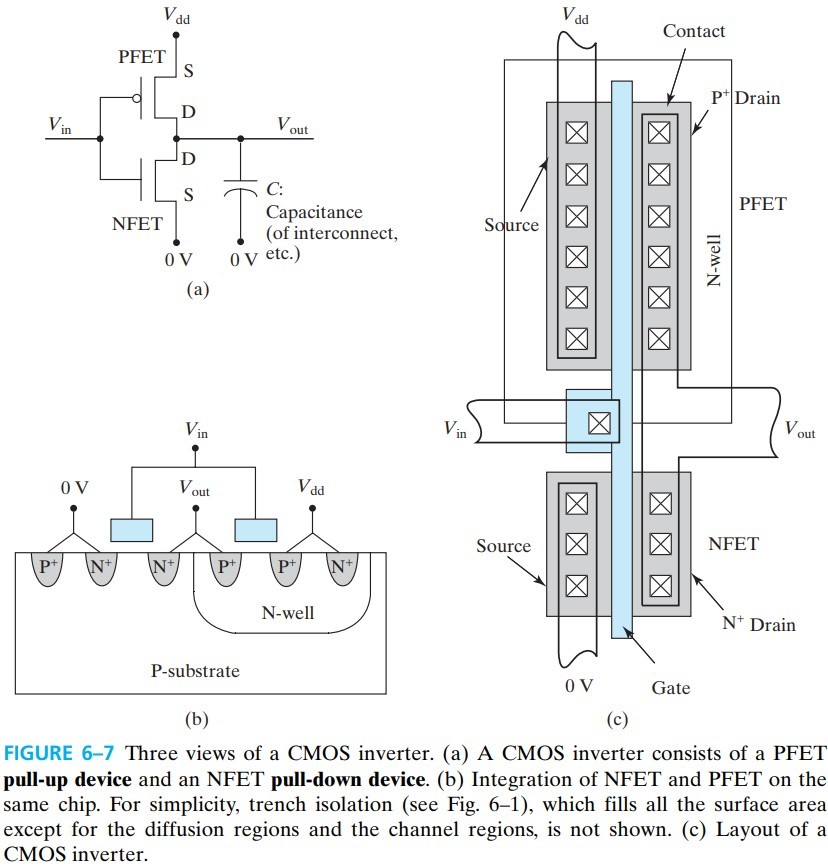
当 $V_\text{in}=V_{dd}$ 时,NFET 开 PFET 关;当 $V_\text{in}=0$ 时,NFET 关 PFET 开。从而实现反相。
6.7.1 Voltage Transfer Curve (VTC)
下面我们来进一步分析 I-V 关系。fig 6-18b 画出了 NET 和 PFET 独立的 IV 曲线。由于 PFET 的 source 是 $2\text{V}$,所以它的 $V_{gs} = V_\text{in} - 2\text{V}$
为了方便分析,我们不妨用 $V_\text{out}$ 作为横轴,其中 NFET $V_{dsN} =V_\text{out}$;PFET $V_{dsP} = V_\text{out} -2 \text{V}$,于是就得到 fig 6-18c。又由于两者是共 $V_\text{in}$ 的,所以图中,同一 $V_\text{in}$ 的实线与虚线的交点就是实际中的 $V_\text{in} / V_\text{out}$ 关系,称为 the voltage transfer characteristic or voltage transfer curve or VTC of the inverter

我们希望 VTC 中间越陡越好,这样可以 maximize the noise tolerance. 同时我们还希望 a large gm, low leakage in the off state, and a small in the saturation region. 这些我们会在后面讨论。

6.7.2 Inverter Speed—The Importance of I_on
Propagation delay 指的是一个输入经过多个串联的 CMOS 后输出的延时,我们一般用 pull-down and pull-up 的平均延迟 $\tau_s$ 来表示。在下图中就是 $V_1$ 上升后,经过 $V_2$ 下拉,再到 $V_3$ 上拉的时间。即电容充放电的时间:
\[\begin{aligned} \tau_d &= \frac{1}{2}(\text{pull-down delay + pull-up})\\ &\approx \frac{C V_{dd}}{4}\left( \frac{1}{I_{onN}}+\frac{1}{I_{onP}} \right) \end{aligned} \tag{6.7.1}\\ I_{on} \equiv \left. I_\text{dsat}\right|_{\max |V_{gs}|}\]$C$ 不只是外接电容,还包括器件内部的电容。
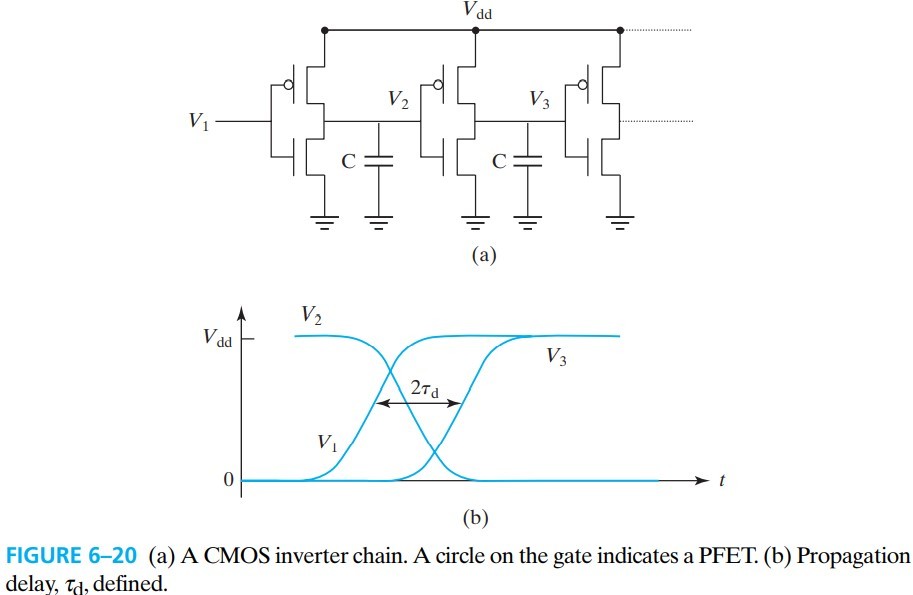
6.7.3 Power Consumption
由于器件在电路中并不是时刻都在工作,而是在特定的时钟周期中工作,可以用 activity factor $k$ 来衡量活跃程度。我们用 dynamic power 来衡量工作功耗,则:
\[P_\text{dynamic} = k CV_{dd}^2 f \tag{6.7.6}\]另外,当器件关闭时有漏电流,导致 static power, or leakage power or stand-by power
\[P_\text{static} = V_{dd} I_\text{off}\]我们会在下一章介绍如何减小漏电流。
\[P=P_\text{static}+P_\text{dynamic}\]6.8 Velocity Saturation
在 2.2.2 介绍散射机构时,提到过 saturation velocity,指的是当电场大到一定程度时,受光子散射影响,载流子速度不再提升。即:
\[v = \frac{\mu_{ns} \mathscr{E}}{1+\mathscr{E}/\mathscr{E}_\text{sat}} \tag{6.8.1}\]那有没有方法继续提高速度呢?有。方法是使得沟道长度 $L$ 很小,使得载流子来不及发射光子,从而达到比 $\mu_{ns} \mathscr{E}_\text{sat}$ 更快的速度,这种现象称为 velocity overshoot.
6.9 MOSFET I-V Model with Velocity Saturation
考虑了 velocity saturation 后的 I-V 特性如下(把 $(6.8.1)$ 代入到 $(6.6.1)$得到):
\[I_{ds} = \frac{\text{long-channel } I_{ds}}{1+\dfrac{V_{ds}}{\mathscr{E}_\text{sat} L}}\\ \text{long-channel }I_{ds} =\frac{W}{L} C_\text{oxe}\mu_{ns} \left(V_{gs} - V_t-\frac{m}{2}V_{ds}\right)V_{ds} \tag{6.6.4}\]可以看出 $L$ 很大时,Velocity Saturation 的影响变小,就得到我们原来的 I-V 关系,称为 long-channel IV model。
从而新的 $V_\text{dsat}$ 可以用下面的公式求出(经过了简化):
\[\frac{1}{V_\text{dsat}}=\frac{m}{V_{gs}-V_t}+\frac{1}{\mathscr{E}_\text{sat}L} \tag{6.9.10}\\ 其中,m =1+3 T_\text{oxe}/W_\text{dmax}\\ \mathscr{E}_\text{sat} = 2v_\text{sat}/\mu_{ns}\]$v_\text{sat}$ is 8×106 cm/s for electrons and 6×106 cm/s for holes.
从而 $I_\text{dsat}$ 为:
\[\begin{aligned} I_\text{dsat} &= \frac{W}{2 m L}C_\text{oxe} \mu_{ns} \frac{(V_{gs}-V_t)^2}{1+\dfrac{V_{gs}-V_t}{m \mathscr{E}_\text{sat}L}}\\ &= \frac{\text{long channel } I_\text{dsat}}{1+\dfrac{V_{gs}-V_t}{m \mathscr{E}_\text{sat}L}} \end{aligned} \tag{6.9.11}\]在两种特殊情况下,上式可以简化:
-
Long-channel or low $V_{gs}$ case, $\mathscr{E}_\text{sat}L \gg V_{gs} − V_t$
简化成原本的形式,即:
\[\begin{aligned} V_\text{dsat} &= \frac{V_{gs}-V_t}{m}\\ I_\text{dsat} &= \frac{W}{2 m L}C_\text{oxe} \mu_{ns} (V_{gs}-V_t)^2 \end{aligned} \tag{6.9.12}\] -
Very short-channel case, $\mathscr{E}_\text{sat}L \ll V_{gs} − V_t$
\[\begin{aligned} V_\text{dsat} &\approx \mathscr{E}_\text{sat}L < \frac{V_{gs}-V_t}{m}\\ I_\text{dsat} &= W v_\text{sat} C_\text{oxe} (V_{gs}-V_t-m \mathscr{E}_\text{sat}L) \end{aligned}\tag{6.9.13}\]
要提高 $I_\text{dsat}$,就要提高 $C_\text{oxe}(V_{gs}-V_t)$,即减小 $T_\text{oxe}$ 并减小 $V_t$ 并增大 $V_{gs}$。可惜的是,$T_\text{oxe}$ 受 oxide tunneling leakage and reliability 限制;$V_t$ 受 MOSFET leakage 限制;$V_{gs}$ 则受电源和功耗限制。
6.13 Output Conductance

从上图中,注意到 $I_\text{dsat}$ 会缓慢增长,这是由短沟道造成的,斜率称为 output conductance:
\[g_{ds} = \frac{\dif I_\text{dast}}{\dif V_{ds}}\]我们希望 $g_{ds}$ 足够小,这样当我们把 MOSFET 当 amplifier 用时,才能得到大的 intrinsic voltage gain(具体模型看书本 230 页)