8.1 Introduction to the BJT
bipolar junction transistor or BJT 是 1948 年由贝尔实验室发明的。尽管现在 IC 里面大部分都是低功耗的 MOS 管,但由于 BJT 具有高速、低噪、高输出功率的优点,所以一些放大器还是用 BJT.
BJT 的结构:
- NPN
- heavily doped N+ emitter 射极
- P-type base 基极
- N-type collector 集电极
- PNP
- heavily doped P+ emitter 射极
- N-type base 基极
- P-type collector 集电极
由于电子的 mobility 比空穴高,所以 NPN 的 transconductance 和 speed 比 PNP 高,因此 NPN 比 PNP 更常用。
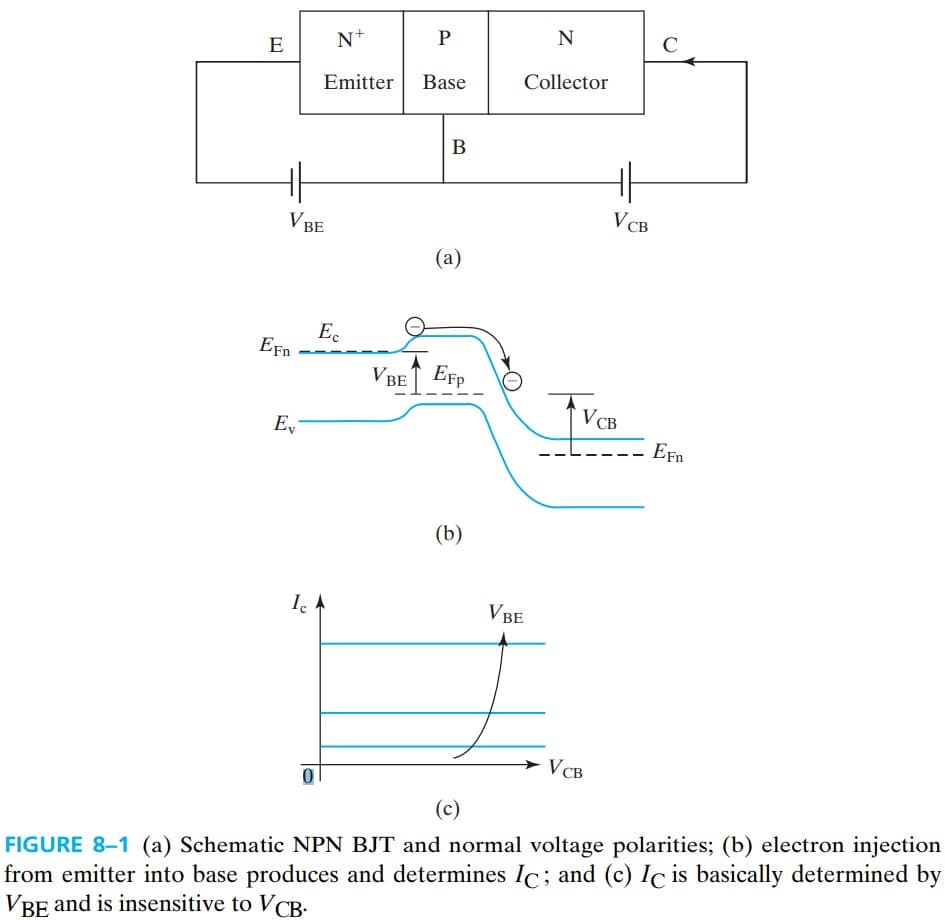
当 $V_{BE}$ 正偏,$V_{CB}$ 反偏时,电子从射极注入,然后在基极扩散,然后受电场作用扫到集电极,从而产生集电极电流 $I_C$. 注入一定的电子,扩散过程中复合率一定,剩下的全跑到集电极,$V_{CB}$ 只起到一个收集作用,所以 $I_C$ 与 $V_{CB}$ 的大小无关,只要 $V_{CB}$ 反偏即可。$I_{C}$ 只与电子注入的多少有关,而根据二极管的公式,电子注入的多少又与 $e^{qV_{BE}/kT}$ 成正比,所以最终可以得到 Fig. 8-1c.
实际中基极接地,基极、集电极电压用对地电压来表示,也就是 $V_{BE},V_{CE}$ ,上图中的 Fig 8-1c 就改成了下图中的 Fig 8-2 b,注意到图中虚线前面部分对应着 $V_{CB}$ 反偏,因为 $V_{CE}=V_{BE}+V_{CE}$,$V_{BE}$ 一般大于 $0.3V$ (锗二极管的导通电压)因此 $V_{CE}<0.3V$ 时,对应着虚线前面那部分。
由于存在 parasitic IR drop(寄生的压降),比较难测量实际加在 BE 上的电压,所以用 $I_B$ 来代替,而 $I_B$ 与 $e^{qV_{BE}/kT}$ 成正比,同时,$I_C$ 也与 $e^{qV_{BE}/kT}$ 成正比(二极管),所以 $I_C$ 正比于 $I_B$.

8.2 Collector Current
上面说过,Electron are injected from emitter to base, and diffuse across the base, and get swept into the collector. This produces a collect current. 而在 PN 结的分析中,我们知道 minority-carrier current is dominated by diffusion current,即:$J_n = q D_n \dfrac{\dif x}{\dif x}$,因此我们可以认为 $I_C$ 主要是 diffusion current:
\[\begin{aligned} I_C &= A_E J_n = \left|A_E q D_B \frac{\dif n}{\dif x}\right|\\ \end{aligned}\]为了求出 $n$ 与 $x$ 的关系式,我们用 electron diffusion equation (就是 4.7 中的 current continuity equation)对基极进行分析:
\[\frac{\dif^2 n'}{\dif x^2} = \frac{n'}{L_B^2}\\ 其中,L_B \equiv \sqrt{D_B \tau_B}\]
我们规定 $x=0$ 为靠近射级一端,从而 boundary conditions 为:
\[正偏 n'(0) = n_{B0} (e^{qV_{BE}/KT}-1) \\ 反偏 n'(W_B) = n_{B0} (e^{qV_{BC}/KT}-1) \approx -n_{B0} \approx 0\]$n_{B0}$ 是原本的少子浓度,即 $n_{B0}=n_i^2 / N_B$,$N_B$ 是 base doping concentration.
解出上面的方程,可以得到:
\[n'(x)=n_{B0} (e^{q V_{BE}/kT}-1) \dfrac{\sinh \left(\dfrac{W_B-x}{L_B}\right)}{\sinh (W_B/L_B)}\]由于在制造过程中,基极很窄(base widths ≈ 0.1 μm),可认为 $W_B \ll L_B$,而 $\sinh x$ 在 0 附近约等于 $x$,所以有:
\[n'(x) = n'(0)\frac{W_B-x}{W_B}\\ = \frac{n_{iB}^2}{N_B} (e^{q V_{BE}/kT}-1) \left( 1 - \frac{x}{W_B}\right) \tag{8.2.6}\]显然,$n’(x)$ reduces to a straight line,从图像中也可以近似看出这一点。

将上述结论代入 $I_C$:
\[\begin{aligned} I_C &= A_E J_n = \left|A_E q D_B \frac{\dif n}{\dif x}\right|\\ &= A_E q D_B \frac{n'(0)}{W_B} (代入上面的解)\\ &= A_E q \frac{D_B}{W_B} \frac{n_{iB}^2}{N_B} (e^{q V_{BE}/kT}-1) \end{aligned} \tag{8.2.7}\]$A_E$ 是 BJT 的面积,准确来说是射级的面积(就是少子注入的面积),$n_{iB}$ 是基区材料的 intrinsic carrier concentration
我们定义一个新的变量 base Gummel number:$G_B$
\[G_B = \frac{n_i^2}{n_{iB}^2} \frac{N_B}{D_B} W_B = \frac{n_i^2}{n_{iB}^2} \frac{p}{D_B} W_B \tag{8.2.10}\]其中,$N_B$ 是基区掺杂浓度,$p$ 是基区 majority carrier concentration. 上面假设的是基区 uniform 掺杂,如果是 nonuniform 掺杂,则可以用积分:
\[G_B = \int_0^{W_B} \frac{n_i^2}{n_{iB}^2} \frac{p}{D_B} \dif x \tag{8.2.11}\]这样一来,$I_C$ 方程可以变为:
\[\begin{aligned} I_C &= A_E \frac{q n_i^2}{G_B} (e^{q V_{BE}/kT}-1)\\ &= I_S (e^{q V_{BE}/kT}-1) \end{aligned}\]通过作 Gummel plot 图(fig 8-5 ),可以求出 $G_B$:$A_E q n_i^2$ 除以 x 轴的截距

$G_B$ 基本上包含了所有可能影响 $I_C$ 的内部因素:
- $n_{iB}$ 材料
- $D_B$
- $N_B$ 或 $p$ 参杂浓度
8.2.1 High-Level Injection Effect
注意到 Fig 8-5 中,在 $V_{BE}$ 较大时,$I_C$ 斜率下降,变成了曲线,the decrease in the slope of the curve at high $I_C$ called high-level injection effect
在 $V_{BE}$ 较大时,注入的 $n’$ 已经大于掺杂浓度 $N_B$,此时称为 high-level injection,根据电中性条件:
\[n' = p' \gg N_B\]也就是说:
\[n \approx p\]根据 pn 结中的推论:
\[n \approx p \approx n_i e ^{qV_{BE}/2kT}\]从而:
\[G_B \propto p = n_i e ^{qV_{BE}/2kT}\]从而:
\[I_C \propto n_i e ^{qV_{BE}/2kT} \tag{8.2.17}\]所以在 Fig 8-5 的转折处,inverse slope 已经变成了 120 mV/decade,但由于 $I_C$ 较大使得 IR drop 对 $V_{BE}$ 的影响较大,导致这里不是 straight line 而是 curve。另外,图中的 $I_{kF}$ 是 knee current,这个在 BJT model for simulation 中是一个有用的参数。
8.3 Base Current
Emitter 发射的电子要到 base,base 发射的空穴要到 emitter,这两个是类似的(但不是完全对称,注意前面都是 $A_E$),所以上面推导的公式可以同样用来求 $I_B$
\[I_B = A_E \frac{q n_i^2}{G_E} (e^{q V_{BE}/kT}-1) \tag{8.3.1}\\ G_E = \int_0^{W_E} \frac{n_i^2}{n_{iE}^2}\frac{n}{D_E} \dif x\\ n=n(x)\]$G_E$ 是 emitter Gummel number
对比 $G_E$ 和 $G_B$ 我们容易发现,由于射级是重掺杂,所以 $G_E$ 中的 $n$ 远大于 $G_B$ 中的 $p$,所以 $I_B$ 远小于 $I_C$,因此 BJT 能起到放大的作用。
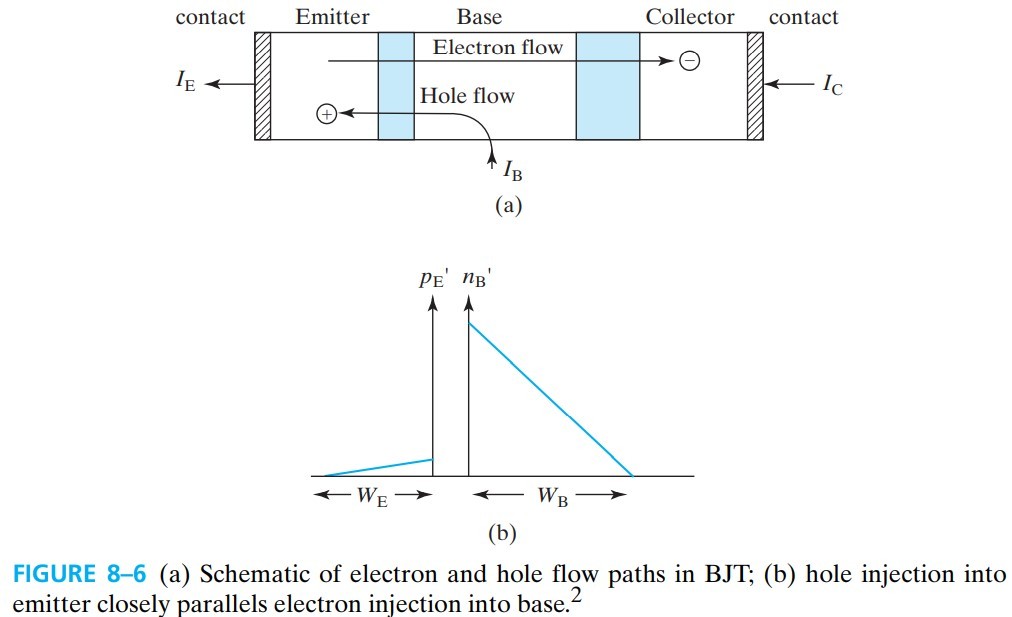
8.4 Current Gain
为了衡量 BJT 的放大性能,我们定义两个参数:
- common-emitter current gain: $\beta_F \equiv \dfrac{I_C}{I_B} \tag{8.4.1}$
- common-base current gain: $\alpha_F = \dfrac{I_C}{I_E}=\dfrac{I_C}{I_B+I_C}$
由于 $I_E=I_B+I_C$,我们可以得出 $\beta_F$ 与 $\alpha_F$ 的关系:
\[\alpha_F =\dfrac{I_C}{I_B+I_C}=\dfrac{I_C/I_B}{1+I_C/I_B}=\frac{\beta_F}{1+\beta_F} \tag{8.4.3}\] \[\beta_F = \frac{I_C}{I_E-I_C}=\frac{I_C/I_E}{1-I_C/I_E}=\frac{\alpha_F}{1-\alpha_F} \tag{8.4.4}\]$\alpha_F$ 大约是 0.99(接近于1),根据上面的关系式,$\beta_F$ 是一个很大的值(100以上)。
我们将上两节推导的 $I_C,I_B$ 代入,可以得到:
\[\beta_F = \frac{G_E}{G_B}=\frac{D_B W_E N_E n_{iB}^2}{D_E W_B N_B n_{iE}^2}\]$D$ 和 $W$ 的取值范围有限,影响不大,主要是 $N_B$ 和 $N_E$ 起作用,所以 emitter 要重掺杂 $N_E \gg N_B$
另外,为了衡量射级注入的电子($I_E$)有多少转变为了 $I_C$,我们定义 emitter efficiency:
\[\gamma_E = \frac{I_C}{I_E}=\frac{I_E-I_B}{I_E}=\frac{I_C}{I_C+I_B}=\frac{1}{1+G_B/G_E}\]8.4.1 Emitter Bnad Gap Narrowing
要增大 $\beta_F$,提高 emitter 的掺杂浓度 $N_E$ 是一种方法,但不幸的是,这会产生 heavy doping effect,导致晶体结构(禁带宽)发生改变,使得 $n_{iE}^2$ 变大:
\[n_{iE}^2 = n_i^2 e^{\Delta E_{gE}/kT}\]8.4.2 Gummel Plot and βF Fall-Off at High and Low $I_C$
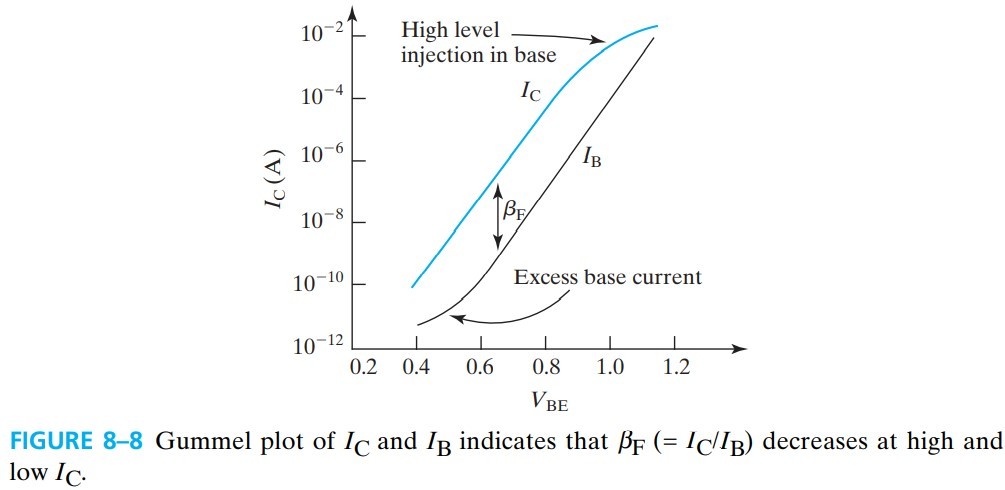
$\beta_F$ 在 $I_C$ 很大或很小时都会下降。
前者的原因在 8.2.1 High-Level Injection Effect 中说过了。因为 $N_E$ 比较大,所以 $I_B$ 不会出现 High-Level Injection Effect.
后者的原因是 4.9.1 the space-charge region (SCR) current
8.5 Base-Width Modulation by Collector Voltage
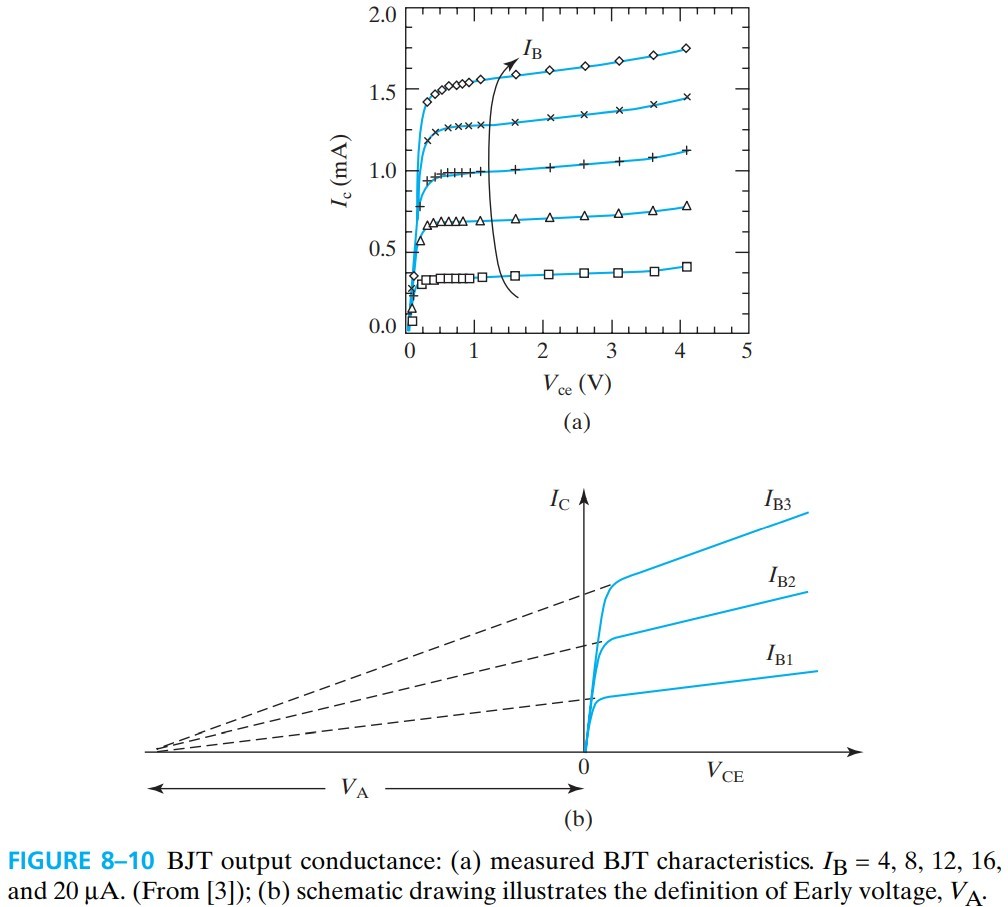
实际 $I_C$-$V_{CE}$ 曲线并不是平的,而是有一定斜率的,用 output conductance $\partial I_C / \partial V_{CE}$,这是由于 base-width modulation (见下图)。
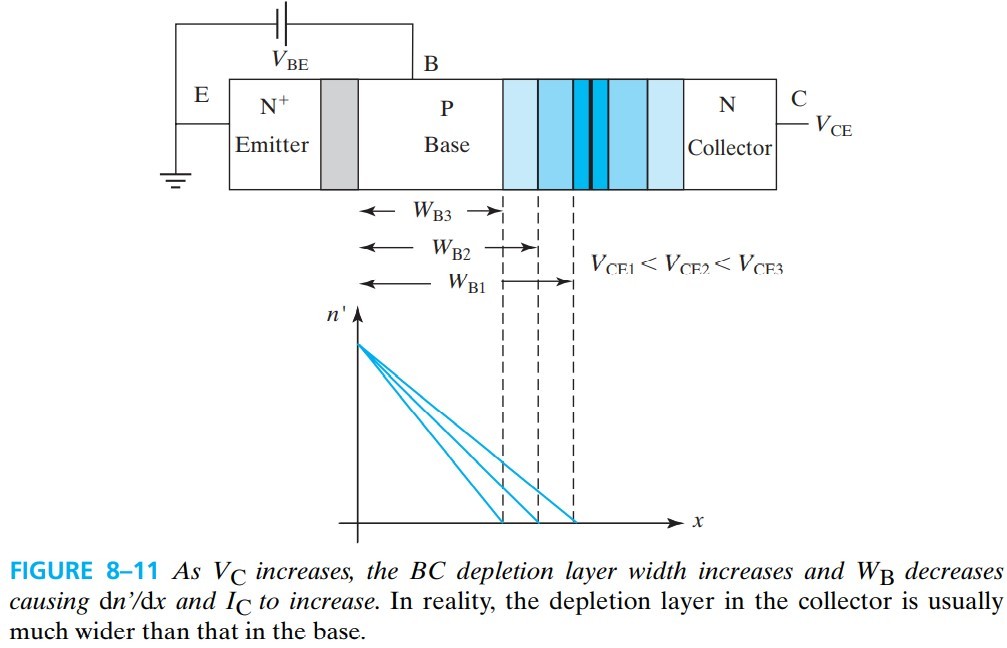
如果反向延长 $I_C$-$V_{CE}$ 曲线,会与横轴交与 Early voltage, $V_A$,从而 output resistance 为:
\[r_0 \equiv \left( \frac{\partial I_C }{ \partial V_{CE}} \right)^{-1} = \frac{V_A}{I_C} \tag{8.5.1}\]我们希望曲线能平一点,即 $r_0$ 大一点,即 $V_A$ 大一点。$V_A\approx 50$V,可以通过下面几种方法增大:
- increase the base width
- increase the base doping concentration, $N_B$, or
- decrease the collector doping concentration, $N_C$.
然而前 2 个会导致 $\beta_F$ 下降,所以只能用第三种方法。
8.7 Transit Time and Charge Storage
当 BE 正偏时,会有多余的 holes 和 electrons 存在于 emitter, base 以及之间的 depletion layer,我们定义这部分多余的电荷为 $Q_F$,而 $Q_F$ 与 $I_C$ 满足如下关系:
\[\tau_F \equiv \frac{Q_F}{I_C}\]上面这条式子可以理解为:$Q_F$ 存储 $\tau_F$ 时间后才会变为 $I_C$,因此 $\tau_F$ 限制了 BJT 在高频时的速度。
8.7.1 Base Charge Storage and Base Transit Time

我们可以简单运算一下 $Q_{F}$ 在基区那部分的过剩电荷 $Q_{FB}$,看 FIg 8-15,图中三角形部分就是 $Q_{FB}$,即:
\[Q_{FB} = q A_E \cdot n'(0) \cdot W_B / 2\]而 $I_C= A_E q D_B \frac{n’(0)}{W_B}$,代入上式可以得到:
\[\frac{Q_{FB}}{I_C} \equiv \tau_{FB} = \frac{W_B^2}{2 D_B}\]$\tau_{FB}$ 就是 base transit time. 可以看出,要提高速度,必须要减小 $\tau_{FB}$,也就是要减小 $W_B$
8.7.3 Drift Transistor-Built-In Base Field
此外,我们可以在 base 建立一个 drift field 来使得电子能更快地通过 base,就是令 base 为不均匀掺杂,如图 Fig 8-16

一般在制造过程中,离子注入就会自然形成这个梯度
8.8 Small-Signal Model
如果 $V_{BE}$ 不在 0 附近,那么 $I_C=I_S (e^{q V_{BE}/kT}-1)$ 就可以简化为:
\[I_C = I_S e^{q V_{BE}/kT}\]如果此时有个小信号 $v_{BE}$ 加在 BE 端,那么就会有相应的电流 $g_m v_{BE}$,即:
\[g_m \equiv \frac{\dif I_C}{\dif V_{BE}}=\frac{q}{kT} I_S e^{q V_{BE}/ kT}=I_C/\frac{kT}{q}\]此时,输入端 BE 端对外等效为一个 $C_\pi$ 和 $r_\pi$ 并联,如图 fig 8-19,我们可以计算出它们的值:
\[\frac{1}{r_\pi} = \frac{\dif I_B}{\dif V_{BE}} = \frac{1}{\beta_F} \frac{\dif I_C}{\dif V_{BE}}=\frac{g_m}{\beta_F}\\ r_\pi = \beta_F / g_m\] \[C_\pi = \frac{\dif Q_F}{\dif V_{BE}}=\frac{\dif}{\dif V_{BE}} \tau_F I_C=\tau_F g_m\]